【垂直腔半导体激光器】
拼译:vertical Cavilty semiconductor Lasers
即谐振腔垂直于衬底的半导体激光器。芯片的两个相互平行的表面是谐振腔的两个反射面。光束由其中一个表面发射出来,故为表面发射器件。与普通半导体激光器相比其主要优点是:(1)器件以动态单纵模工作,而且保持这个纵模的温度范围较宽(>60K);(2)它具有圆形光斑,而且光束发散角较小(~10°);(3)可以在大片子上自动检测和筛选芯片,有利于大批量生产;(4)容易制作这种器件单片集成的二维列阵;(5)容易实现这种器件和电子器件的单片集成。 表1 典型多层异质结构片子的外延层 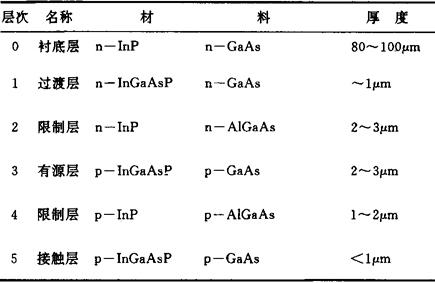
垂直腔半导体激光器主要是采用在n-InP或n-GaAs衬底上生长的多层异质结构片子制作的。典型多层异质结构片子的外延层材料和厚度如表1所示。生长方法有液相外延(LPE)、分子束外延(MBE)和金属有机源化学汽相沉积(MO-CVD)。多层异质结构片子的核心是由有源层及其上下两个限制层组成的双异质结构。在加正向电压后,电子被注入并限制在有源层内,与这里的空穴复合而发光,并产生光放大。过渡层和接触层是因工艺要求而加上的。片子的原生表面是镜面;衬底的背面被抛光成镜面。这两个镜面构成谐振腔的两个反射面,由它们提供光反馈,在腔内建立起稳定的光振荡,即激光。将芯片正面朝下键合在热沉上,而由其背面出光。InGaAsP/InP器件的有源区是InGaAsP,发射波长为1.3μm或1.5μm,主要用于长距离光纤通信系统。AlGaAs/GaAs器件的有源区是GaAs,发射波长为0.85μm,主要用于光盘、光传感、光互连、光计算和光信息处理系统。1977年,日本伊贺健一提出了垂直腔半导体激光器的设想。接着,日本和美国的研究人员开展了艰苦的技术攻关,终于实现了历史性突破,为今后垂直腔半导体激光器的发展和应用打下了坚实的基础。垂直腔半导体激光器的发展过程如表2所示。表2 垂直腔半导体激光器的发展过程 
1979年,以伊贺为首的研究小组,采用在n-InP衬底上生长LPE的片子,制作了第1个垂直腔半导体激光器。这是结构最简单的器件。在衬底上只生长双异质结构,而没有过渡层和接触层。正面蒸发圆形Au/Zn/Au,并合金成欧姆接触;既是正电极,又是反射膜。背面蒸发环形Au/Sn/Au,并合金成欧姆接触,作为负电极;再蒸发Au,作为反射膜。正面圆形电极起水平电流限制作用,有源区呈圆形。这个InGaAsP/InP垂直腔半导体激光器只能在低温(77K)下脉冲工作。然而,人们追求的目标是获得在室温(300K)下连结工作的器件。接着,在器件结构上作了如下改进:(1)正面,首先腐蚀出圆台,然后将它掩埋起来,圆台周围掩埋材料内的反向结阻止电流通过。这就是掩埋异质结构。(2)背面,将有源区下面的衬底材料腐蚀掉形成平底坑,坑底镜面为新的反射面,因而腔长由~100μm缩短到10μm以下,这就是短腔器件。此后,均采用表Ⅰ所示的片子来制作短腔掩埋异质结构器件。在改进器件结构的同时,还研究了AlGaAs/GaAs垂直腔半导体激光器。由于GaAs的光损耗小于InGaAsP的光损耗,AlGaAs/GaAs器件与InGaAsP/InP器件相比,更容易在室温下连续工作。当时的主要矛盾是如何提高反射率。为了提高反射率,必须将正面的反射膜和欧姆接触电极分开,即采用环形电极。1984年,正面采用圆形SiO2/Au/Zn/Au反射膜和环形Au/Zn/Au合金欧姆接触电极,获得了在室温下脉冲工作的AlGaAs/GaAs垂直腔半导体激光器。1986年,背面采用多层SiO2/TiO2布拉格反射膜,获得了在低温下连续工作的AlGaAs/GaAs垂直腔半导体激光器。1989年,采用在n-GaAs衬底上MO-CVD生长的片子制作的AlGaAs/GaAs器件实现了在室温下连续工作的目标,这是历史性的突破。这个垂直腔半导体激光器是短腔掩埋异质结构器件,正面蒸发SiO2/TiO2/SiO2/Au反射膜,背面蒸发多层SiO2/TiO2布拉格反射膜。结构参数是:反射率大于0.95;谐振腔长度~5.5μm;有源层厚度~2.5μm;有源区直径~10μm。性能参数是:阈值电流为36mA;光输出功率为0.8mW;微分量子效率为9%;器件以稳定的单纵模工作,光谱宽度小于1×10-10m;保持这个纵模的温度范围大于60K;近场图呈圆形,直径~4μm;远场图亦呈圆形,光束发散角~13度。在研究分立器件的同时,还研究了垂直腔半导体激光器二维列阵。1985年,实现2×2的InGaAsP/InP器件列阵在低温下脉冲工作;1988年,实现5×5的AlGaAs/GaAs器件列阵在室温下脉冲工作。垂直腔半导体激光器二维列阵是平行光逻辑系统和平行光传输系统的唯一理想的光源。当然,它也可以作为一个大功率光源。1990年,美国加里福尼亚大学的AlGaAs/GaAs垂直腔半导体激光器也实现了在室温下连续工作。中国已将垂直腔半导体激光器列入了国家高技术研究和发展计划(863计划)。最近,垂直腔半导体激光器二维列阵的进展是惊人的。1991年,美国Bell Core推出了在室温下连续工作的AlGaAs/InGaAs/AlAs/GaAs垂直控半导体激光器二维列阵。这是7×20的多波长器件列阵,其中每个器件的发射波长均不相同。发射波长~9800×10-10m,相邻器件的波长差为3×10-10m。接着,使用其中的4个器件,成功地演示了波分复用光纤传输实验。他们的器件采用在n-GaAs衬底上MBE生长的片子,其中在AlGaAs/InGaAs多量子阱有源层上下分别为p型和n型多层AlAs/GaAs布拉格反射层。正面和背面分别形成Au/Be/Au和Au/Ge/Au欧姆接触电极。水平电流限制由质子轰击芯片表面来提供,电流只通过未被轰击的区域。有源区面积为20μm×20μm。阈值电流为8.5±3mA。如果将有源区直径减小为2~3μm,则可以使阈值电流降低至1mA以下,将二维列阵的集成度提高几个数量级,这是今后的主要奋斗目标。此外,波长连续可调的垂直腔半导体激光器的研究,大功率垂直腔半导体激光器锁相二维列阵的研究,以及可见光垂直腔半导体激光器及其二维列阵的研究,都是十分引人注目的课题。【参考文献】:1 Soda H,et al.Japan.J.Appl.Phys.,1979,18:2329~23302 Okuda H,et al.Japan.J.Appl.Phys.,1981,20:L563~L5663 Motegi Y,et al.Electron.Lett.,1982,18:461~4634 Iga K,et al.Appl.Phys.Lett.,1984,45:348~3505 Uchiyama S,et al.Electron.Lett.,1985,21:162~1646 Kinoshita S,et al.Japan.J.Appl.Phys.,1987,26:410~4157 Kinoshita S,et al.IEEE J.Quantum Electron.,1987,QE23:882~8888 Koyama F,et al.Appl.Phys.Lett.,1988,52:528~5299 Koyama F,et al.Appl.Phys.Lett.,1989,55:221~22210 Chang C J.-Hasnain.J.Lightwave Technology,1991,9:1665~1673(长春光学精密机械学院杜宝勋教授撰) |